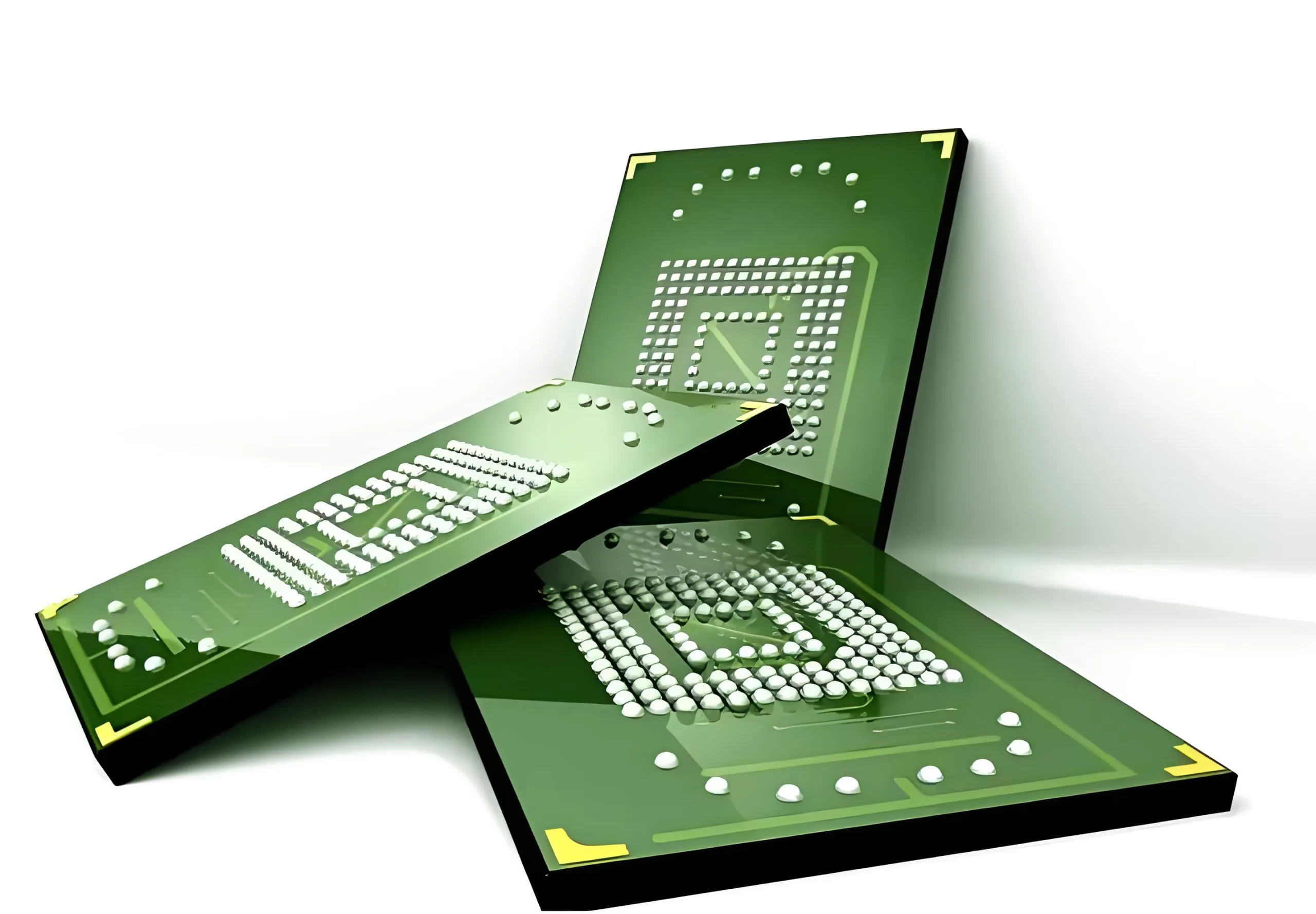
BGA -Defekt- und Misserfolgsanalyse.
In diesem Artikel werden mögliche Montageanomalien im Zusammenhang mit der Montage von BGA-Komponenten identifiziert. Es beschreibt Postprozessfehler im Zusammenhang mit den Eigenschaften der Montagestruktur sowie Variationen bei den als BGA-Anschlüssen verwendeten Lotkugeln. In vielen Fällen, Wenn die Merkmale auf Verbindungspunktfehler zurückgeführt werden, Eine spezielle Diskussion über die Metallographie der Anschlüsse ist erforderlich. Die endgültige Verbindungspunktstruktur wird ebenfalls analysiert.
1.Lötenresist definierte BGA -Bedingungen
BGA -Pads werden auf zwei Arten definiert: Lötmittelresist definiert (SMD), Wo die Padgröße größer ist als die Öffnung im Lötmittel widerstand, Lassen Sie den geschmolzenen BGA -Lötball nach dem Reflow -Löten kontaktieren; und eine andere Methode, die als geätzter oder nicht gesalterem Widerstand definiert ist (NSMD), Wo der Lötmittelresist der Öffnung größer ist als das Kupferpolster, Daher kontaktiert der Lötkugel den Lötmittel nicht nach dem Reflow -Löten. Siehe Abschnitte 1.1 Und 1.2 für Details.
1.1 Lötmittelresist definiert vs. Nicht definierte Pads

Die Gründe und Lösungen für das Erscheinungsbild von Lötmittel Resist definierter und nicht definierter Pads
1.2 Lötmittelresist definierte Pads auf Produktplatten
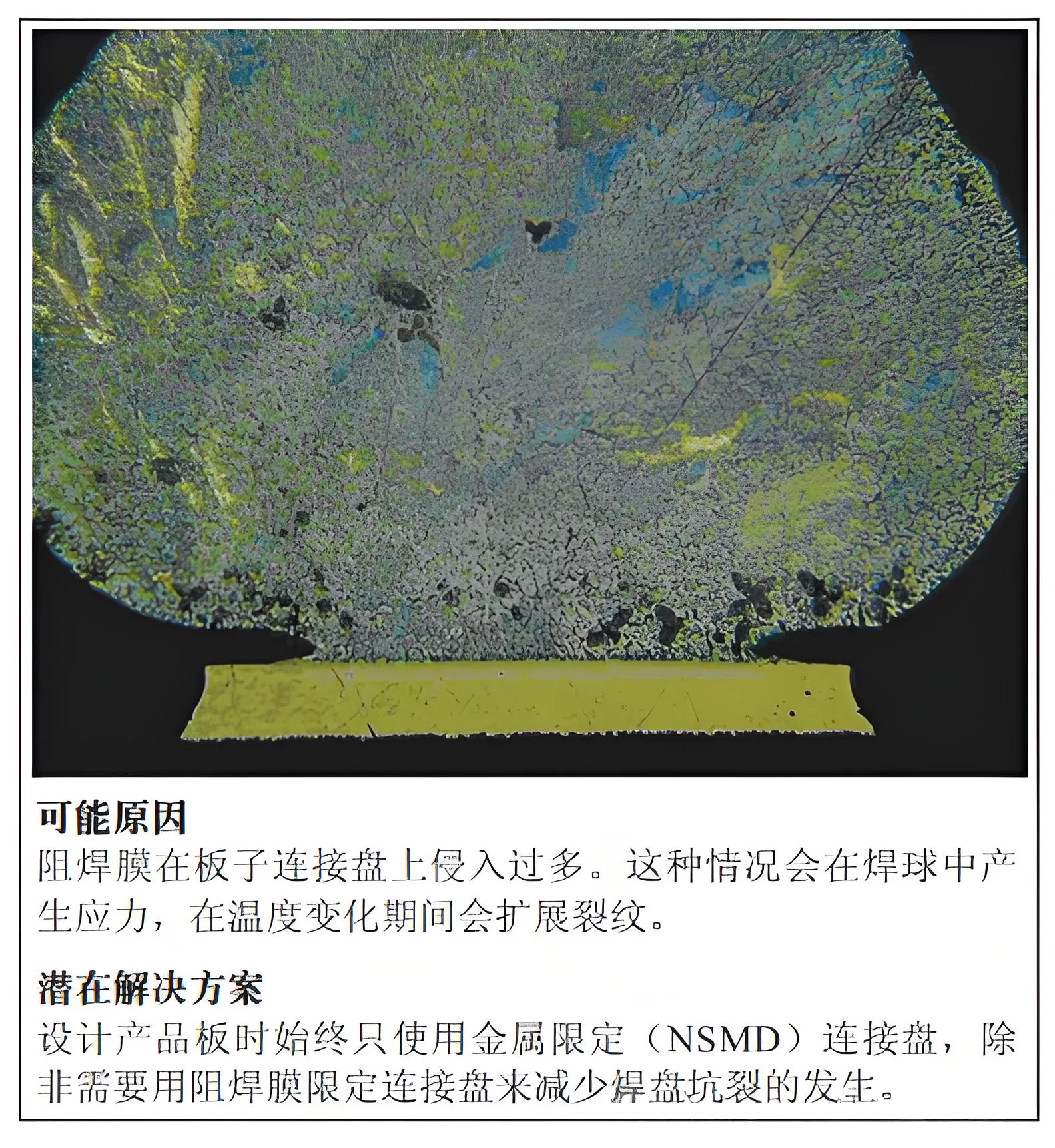
Analyse und Lösung für die Ursachen von Lötmittelresist -Begrenzungspads auf PCB -Boards
Definierte Lotstempfleger können für entsprechende nicht kritische oder funktionelle Stifte verwendet werden, da SMD-Pads dazu beitragen können. Jedoch, Es ist zu beachten.
Der Hauptnachteil von Lötmittel Resist Defined Pads liegt in der durch SMD erzeugten Spannungskonzentration (Lötmittelresist definiert) Lötstellen, Dies wird zum Ursprung des Lötenversagens und verringert die Zuverlässigkeit. Wie in Punkt gezeigt 3 unten, Für die gleiche Lötverbindung, Der Ermüdungslebensfaktor bei der Verwendung nicht sorrerer resist definiert (NSMD) Erhöht sich um einen geschätzten 1.25 Zu 3 Zeiten im Vergleich zu SMD -Pads, mit größeren Verbesserungen unter strengeren Lastbedingungen.
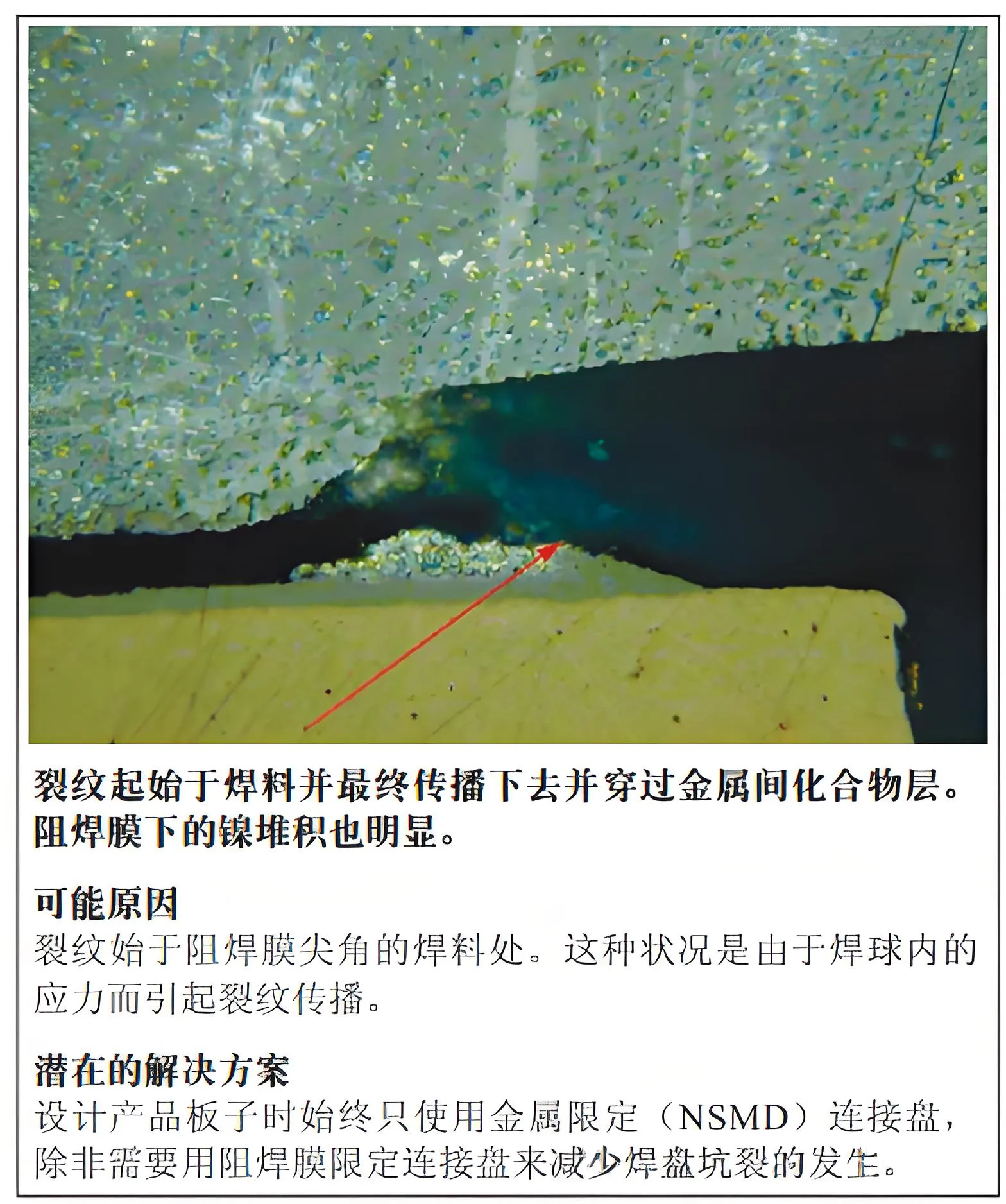
Ursachen und Lösungen für Risse in SMD -Lötverbindungen
SMD -Pads haben drei Hauptnachteile
- Weniger Substratbereich verursacht eine Spitzenrennung
- Verlust der Pad -Größe Genauigkeit
- Reduzierte Zuverlässigkeit, Da es sich um den Ursprung des frühen Misserfolgs bei Lötverbindungen handelt
2.Übermäßiger Zusammenbruch von BGA -Lötkugeln
Formulierte BGA -Lötkugeln kollabieren typischerweise von ihrer ursprünglichen Größe von 750 μm auf etwa 625 μm. Nachdem das Paket an das Board gelötet wurde, Die Lötkugeln kollabieren auf etwa 500 μm. Jedoch, Wenn es im Paket Kühlkörper oder Wärmeblöcke gibt, Die Lötbälle können auf 300 μm fallen. Wenn sich die Lötbälle flach machen, Ihre Zuverlässigkeit nimmt aufgrund der begrenzten Löthöhe und der Flexibilität der Lötverbindungen ab. Auch, Die Erweiterung der Lötbälle kann den erwarteten Pitch -Lücken überschreiten. Eine bessere Annäherung ist eine anfängliche Reflow -Reduktion von ungefähr 10% Höhe; mit dem zusätzlichen Gewicht der Kühlkörper, Diese Zahl kann zunehmen 25% der ursprünglichen Höhe (Lötkugeldurchmesser). Das Muster der Verbindungspolster und die Lücke im Lötmittelresist spielen auch eine Rolle in der Analyse. Die extremen Werte dieser Situation sind in Abschnitten gezeigt 2.1 Zu 2.4.
2.1 BGA Lötkugel ohne Kühlkörper, 300μm Haltungshöhe

Die Ursache und Lösung für den Zusammenbruch von BGA -Kugeln ohne Wärmeissipationsblock
2.2 BGA Lötkugel mit Kühlkörper, 375μm Haltungshöhe

Der Grund und die Lösung für den kugelförmigen Zusammenbruch von BGA mit Kühlkörper
2.3 BGA Lötkugel mit Kühlkörper, 300μm Haltungshöhe

Der Grund und die Lösung für den kugelförmigen Zusammenbruch von BGA mit Kühlkörper
2.4 Kritische Lötpastebedingungen
Die Menge an abgelagerte Lötpaste ist hilfreich für geformte BGA -Verbindungen, ist jedoch nicht sehr kritisch für die Bildung guter Lötverbindungen, Da können die Lötbälle selbst als Quelle des Lötens fungieren. Jedoch, Für Keramik -BGA (CBGA), Die Ablagerung ausreichender Lötpaste ist sehr wichtig. Für eine 890 μm CBGA, Die empfohlene Menge an Lötpaste beträgt 0,12 mm³, mindestens 0.08 mm³. Wenn nicht genug Lötpaste abgelagert wird, Wie im Abschnitt gezeigt 3.1, Die Zuverlässigkeit der Lötverbindung kann problematisch sein. Löten muss zu Hochtemperaturlötbällen oder -pfosten hinzugefügt werden.
2.5 Übermäßige dicke Paste -Ablagerung
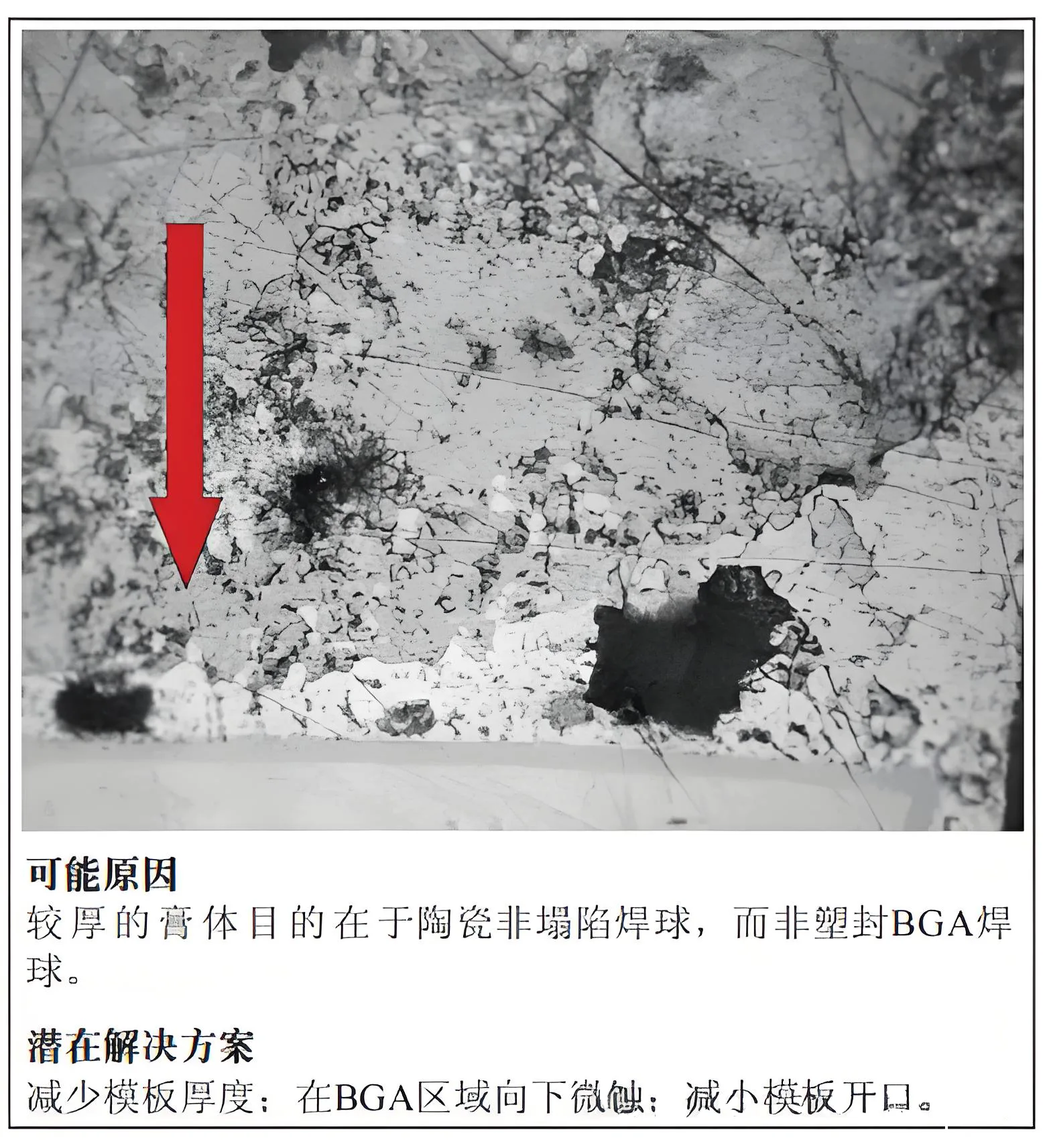
Ursachen und Lösungen für übermäßige Pasteablagerung
2.6 Hohlraumerkennung durch Röntgen- und Abschnitt
Übertragungs-Röntgenstrahl kann das Vorhandensein von Hohlräumen erkennen (Lichtbereiche) und verwandte X-Y-Positionen. Diese Technik kann auch ungleiche oder fehlende Lötbälle erkennen (Verschiedene dunkle Bilddurchmesser), Beispiele, die im Abschnitt angezeigt werden 2.7. Jedoch, Röntgenabschnitte ist erforderlich, um die Vertikale zu bestimmen (Z-Achse) Hohlraumposition in der Lötverbindung.
2.7 Hohlräume und ungleiche Lötkugeln

Hohle und ungleichmäßige Lötkugeln und Lösungen
Es gibt viele Gründe für die Bildung von Hohlräumen in BGAs. Obwohl häufigere Hohlräume im Abschnitt gezeigt werden 2.7, Hohlräume stellen kein Zuverlässigkeitsrisiko dar. Hohlräume wie die im Abschnitt gezeigten 2.8 kann standhalten 1000 Wärmezyklen (Kein Schock, 0-100°C). Auch in einigen Tests, Hohlräume reduzieren keine Ermüdungslebensergebnisse, Übermäßige Hohlräume in Lötverbeinen zeigen Probleme mit dem Design an, Verfahren, oder Materialien. Die Produktzuverlässigkeit sollte ebenfalls verifiziert werden.
2.8 Eierschalenlücken

Die Ursachen und Lösungen für die Eierschalenporosität
3.Verzerrung und Verzerrung von BGA -Substraten
In normalen Montage -Reflow -Prozessen, geformte BGAs neigen dazu, sich zu verziehen. Es kann ein Verstand auf dem BGA -Substrat oder dem Produkt -PCB auftreten. Das Ergebnis ist gestresste Lötverbindungen, die offen oder Kurzschlussbedingungen werden. Temperatur (Reflow -Profil), BGA -Struktur, Lötpastevolumen, und Kühlbedingungen bringen potenzielle Mängel mit sich. Ecklötkugelshorts sind ein Hinweis auf eine BGA -Verzerrung, mit den Ecken des BGA -Pakets nach innen verzerrt (weinende BGA).
Löthorts treten zwischen benachbarten und/oder gegenüberliegenden BGA -Ecken aufgrund des Substrats nach unten biegen (weinendes Gesicht), Belastung der Ecklötbälle. Das gleiche Phänomen führt dazu, Wenn sich das Substrat von einem weinenden Gesicht zu einem lächelnden Gesicht ändert, Wie in Abschnitten gezeigt 3.1 Und 3.2. Wenn BGA -Substrate und Chips dünner werden, Das Paket steigt auch an. Einen robusten SMT -Prozess haben, Es wird empfohlen zu überprüfen. Dieser Prozess sollte genau überwacht werden, um sicherzustellen, dass keine zusätzlichen Mängel wie Lötbrücken oder Perlen auftreten.
3.1 BGA Interpose Substratverzerrung

Offene Schaltkreise von Ecklötbällen sind ein Hinweis auf BGA -Verzerrungen, mit den Paketecken nach oben heben. Dieser offene Stromkreis, Wie im Abschnitt gezeigt 3.2, Kann durch Verwendung zusätzlicher Lötpastevolumen minimiert werden.
3.2 Lötverbindungsverbindungsleitungskreis aufgrund des Interposer -Substrats -Verzugs

Der Grund und die Lösung für den offenen Kreislauf, der durch PCB -Verzerrungen verursacht wird
Das Aufbringen überschüssiger Lötpaste ist keine Lösung für dieses Problem. Die Identifizierung der Ursache und der Bekämpfung der Anomaliegründe ist wichtiger für die Festlegung eines robusten Prozesses. Ändern der Schablonenöffnung, um Lötpaste auf der Platine einzureichen, wie wenn der Reflow -Prozess optimiert wurde, Das BGA -Paket oder das BGA -Interposer -Substrat kann nicht neu gestaltet werden, oder die Produktkarte kann nicht neu gestaltet werden. Zusätzlich, Anomalien treten wahrscheinlich weiter auf, und bevor Sie einen Prozessänderungen vornehmen, Das Inventar von Löten und Komponenten sollte berücksichtigt werden. Wenn Sie sich für überschüssige Lötpaste entscheiden, um die Open Circuits der Ecklötkugel zu korrigieren, Überwachen Sie diesen Prozess genau, um sicherzustellen, dass keine zusätzlichen Mängel wie Lötbrücken oder Perlen auftreten.
Löten gemeinsame Bedingungen
Nächste, Wir diskutieren die Bedingungen der Lötkugeln, die mit der Montagestruktur und dem Interposer -Substrat verbunden sind. Für jeden Fall, Erklärungen werden zu den Ursachen dieser Erkrankung gegeben.
4.1 Ziellötbedingungen

Ursachen und Lösungen für offene Schaltkreise an Schweißstellen aufgrund gezielter Schweißbedingungen
4.2 Über oxidierte Lötbälle

Der Grund für den offenen Stromkreis, der durch überoxidierte Lötkugeln und ihre Lösung verursacht wird
4.3 Zeichen der Benetzbarkeit

Gründe für und Lösungen, um gemeinsame offene Schaltkreise durch Enttäuschung verursacht zu werden
4.4 Fehlbedingungen

Die Ursache und Lösung von Lötverbindungsfehlern, die durch Lötkapelplätze verursacht werden
4.5 Zinn/Blei -Lötkugelbewertung

Gründe und Lösungen für Lötunverbindungen, die durch Zinn-/Blei -Lötkugeln verursacht werden
4.6 Sacklegierung

Die Gründe und Lösungen für gemeinsame Lötunfehler, die durch SAC -Legierung verursacht werden
4.7 Kalte Lötverbände

Kalte Lötpunkte, die durch kaltes Lötmittel und ihre Lösungen verursacht wurden
4.8 Unvollständige Verbindungen, die durch Pad -Kontamination verursacht werden

Ursachen und Lösungen für unvollständige Verbindungen aufgrund einer Verunreinigung der Verbindungsscheibe
4.9 Kontamination durch deformierte Lötkugeln verursacht

Die Ursache und Lösung von Lötverbindungsfehlern aufgrund von Verunreinigungen durch deformierte Lötkugeln
4.10 Deformierte Lötbälle

Ursachen und Lösungen für Lötunverbindungen, die durch deformierte Lötbälle verursacht werden
4.11 Unzureichender Lötmittel und Fluss für eine angemessene Gelenkbildung

Die Ursachen und Lösungen für Lötunverbindungen, die durch unzureichende Lötmittel und Fluss verursacht werden
4.12 Reduzierter Kontaktbereich der Terminals

Gründe für Lötunverbindungen, die durch reduzierte Anschlussfläche und Lösungen verursacht werden
4.13 Lötbrücken

4.14 Unvollständiger Lötmittel -Reflow

Gründe und Lösungen für gemeinsame Lötunfehler, die durch Lötmittel -Reflow verursacht werden
4.15 Trockenlötgelenke

Die Ursachen und Lösungen von Lötunverbindungen, die durch leere Lötung verursacht werden
4.16 Open Circuits ohne Beschäftigungslötgele

Ursachen und Lösungen für Lötunverbindungen aufgrund von offenen Schaltkreisen
4.17 Lötverbindungen von Kisseneffekten (Hüpfen)

Der Grund für die Bildung von Lötverbindungen von Kisseneffekten und seiner Lösung
 UGPCB-LOGO
UGPCB-LOGO

