La technique de coupe des unités individuelles des plaquettes puis de les emballer est depuis longtemps la norme pour emballer les circuits intégrés semi-conducteurs depuis des décennies. Cependant, Cette approche n'est pas actuellement adoptée par les principaux fabricants de semi-conducteurs en raison des coûts de fabrication élevés et de la composante RF croissante des modules d'aujourd'hui. Ainsi, L'émergence de l'emballage au niveau des plaquettes (WLP) a conduit à un changement de paradigme dans le développement d'emballages à faible coût. WLP est une technologie d'emballage de niveau de plaquette avant la coupe des dispositifs d'emballage de la plaquette.
En utilisant des outils et des processus standard, WLP agit comme une extension du processus de fabrication de la plaquette. Finalement, La matrice WLP fabriquée aura un coussin métallisé à la surface de la puce et un point de soudure déposé sur chaque coussin avant de couper la plaquette. Ce, à son tour, Rend le WLP compatible avec les processus d'assemblage des PCB traditionnels et permet des tests d'appareils sur la plaquette elle-même. Par conséquent, c'est un coût relativement faible et un processus efficace, D'autant plus que la taille de la plaquette augmente et que la piste se rétrécit. La taille des plaquettes a augmenté au cours des dernières décennies, depuis 4, 6, et 8 pouces de diamètre pour 12 pouces. Il en résulte une augmentation du nombre de matrices par tranche, ce qui abaisse les coûts de fabrication. En termes de performances électriques, Le WLP est supérieur aux autres technologies d'emballage, dans le sens où une fois qu'un appareil WLP est intégré dans un module RF dense, Il en résulte une réduction significative du couplage parasite EM car l'interconnexion entre l'appareil et le PCB est relativement courte, Contrairement à l'interconnexion à liaison filaire utilisée dans certains types de technologies CSP.
Technologie de la médaille de puce WLP
Technologie de la montée en puissance, également connu sous le nom de connexion à la puce d'effondrement contrôlée (C4), est l'une des nombreuses technologies d'assemblage de puces développées par IBM dans les années 1960. Bien que la technologie d'emballage basée sur la liaison filaire soit plus flexible en termes de capacité inductive gratuite pour le débogage de laboratoire après la construction du matériel, et fournit également une bonne conductivité thermique, L'utilisation de renflements de soudure dans la technologie d'emballage à la molette fait la connexion électrique entre le substrat du package et la puce fournit une réduction de taille relative, latence réduite, et une meilleure isolement en termes de ses broches d'entrée et de sortie. Chiffre 1 illustre la structure de base de la filière sur le substrat, avec une boule de soudure en haut de la colonne Cu qui pousse sur la surface de la puce. Le joint de soudure est généralement encapsulé avec un composé de moule de remplissage pour fournir un support mécanique pour le joint de soudure.

Technologie de la médaille de puce WLP
Package de niveau de puce WLP
Emballage d'échelle de puce (Fournisseur de services de chiffrement) est l'une des méthodes d'emballage les plus couramment utilisées dans l'industrie de la microélectronique et des semi-conducteurs. Alors que plusieurs types de technologies CSP sont déjà disponibles pour les fabricants de micropuces, Les nouveaux types continuent d'émerger pour répondre à la demande de produits qui prennent en charge les nouvelles fonctionnalités et les nouveaux produits spécifiques à l'application. Ces exigences d'emballage peuvent varier en fonction du niveau de fiabilité requis, coût, fonctionnalités supplémentaires, et taille globale. Comme son nom l'indique, La taille de l'emballage du CSP est à peu près la même que la taille de la folie, qui est l'un de ses principaux avantages. En adoptant le processus de fabrication du WLP, CSP est constamment en cours de développement pour atteindre le plus petit rapport de taille de package-die. Comme le montre la figure 2, le tableau de la grille à billes (BGA) Le style de CSP dans le package permet plusieurs interconnexions tout en simplifiant le câblage PCB, Augmentation du débit de l'assemblage des PCB et réduction des coûts de fabrication.
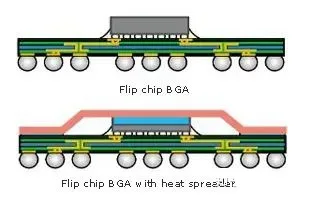
Emballage de niveau de plaquette
Autres technologies d'encapsulation
Il existe plusieurs autres formes d'emballages IC intégrés qui permettent une intégration transparente dans les packages de modules personnalisés en application. Ensemble quadruple (CFP) est l'une des premières technologies de package IC de montage de surface,où la structure de l'emballage est composée de quatre côtés avec des fils d'interconnexion étendus, Comme le montre la figure 3(un). Les fils surélevés sont connectés à la trame de package pour former un métal-isolant-métal (Mim) type de condensateur entre les fils et le métal en puce, qui peut être utilisé comme élément correspondant. Cette technique convient aux CI de taille millimétrique où le nombre d'épingles périphériques dans l'emballage peut atteindre plus que 100 épingles. Il y a plusieurs dérivés de ce type d'encapsulation, Selon le matériau utilisé, comme un pack de quad en céramique, pack de quad mince, pack de quadruple en plastique, Pack de quadruple en plastique) et pack plat en métal (MQFP). Le QFN, Quad plat pas de plomb, montré sur la figure. 3(b) est l'une des nombreuses technologies d'emballage montées sur surface formées à partir d'un cadre de plomb de cuivre plat et d'un emballage en plastique utilisé comme pavé de transfert de chaleur pour le radiateur. La liaison filaire peut également être utilisée pour les interconnexions, Et puisque les lignes de liaison ne sont pas seulement des conducteurs mais aussi des inductances, Ils affectent généralement les performances des appareils sous cette technique d'encapsulation, à moins qu'il ne soit considéré comme faisant partie de la conception globale. Bien que le QFN soit une interconnexion composée de quatre côtés, le bi-plan non LELD (DFN) sont également apparus et former les deux côtés du plan d'interconnexion.
 LOGO UGPCB
LOGO UGPCB