ウェーハから個々のユニットを切断し、その後パッケージ化する技術は、数十年にわたって半導体統合回路のパッケージングの標準でした. しかし, このアプローチは、製造コストが高く、今日のモジュールのRFコンポーネントの増加により、主要な半導体メーカーに現在採用されていません。. したがって, ウェーハレベルのパッケージの出現 (WLP) 低コストのパッケージの開発にパラダイムシフトをもたらしました. WLPは、ウェーハパッケージングデバイスの切断前のウェーハレベルの包装技術です.
標準のツールとプロセスを使用します, WLPはウェーハ製造プロセスの拡張として機能します. 最終的に, 製造されたWLPダイには、チップの表面に金属化されたパッドがあり、ウェーハを切る前に各パッドにはんだドットが堆積します. これ, 順番に, WLPを従来のPCBアセンブリプロセスと互換性のあるものにし、ウェーハ自体でデバイステストを許可します. 結果として, 比較的低コストで効率的なプロセスです, 特にウェーハのサイズが増加し、チップが縮小するにつれて. ウェーハのサイズは過去数十年にわたって増加しています, から 4, 6, そして 8 直径がインチ 12 インチ. これにより、ウェーハあたりのダイ数が増加します, 製造コストを削減します. 電気性能に関して, WLPは他のパッケージングテクノロジーよりも優れています, 一度WLPデバイスが密なRFモジュールに統合されるという意味で, デバイスとPCB間の相互接続が比較的短いため、EM寄生カップリングが大幅に減少します。, いくつかのタイプのCSPテクノロジーで使用されるワイヤー結合相互接続とは異なり.
WLPチップフリップチップテクノロジー
フリップチップテクノロジー, 制御された崩壊チップ接続としても知られています (C4), 1960年代にIBMが開発したいくつかのチップアセンブリテクノロジーの1つです. ワイヤボンディングベースのパッケージングテクノロジーは、ハードウェアが構築された後の実験室のデバッグのための無料の誘導機能の観点からより柔軟ですが, また、優れた熱伝導率を提供します, フリップチップパッケージングテクノロジーではんだ膨らみを使用すると、パッケージ基板とチップとの間の電気接続が相対的なサイズの削減を提供します, レイテンシーの減少, 入力ピンと出力ピンに関してより良い分離. 形 1 基板上のチップダイの基本構造を示しています, チップ表面で成長するCUカラムの上部にはんだボールがあります. はんだジョイントは通常、フィラー金型化合物でカプセル化され、はんだジョイントの機械的サポートを提供します.

WLPチップフリップチップテクノロジー
WLPチップレベルパッケージ
チップスケールパッケージ (CSP) マイクロエレクトロニクスおよび半導体業界で最も一般的に使用されるパッケージング方法の1つです. マイクロチップメーカーはすでにいくつかのタイプのCSPテクノロジーを利用できますが, 新しいタイプは、新機能と新しいアプリケーション固有の製品をサポートする製品の需要を満たすために出現し続けています. これらのパッケージング要件は、必要なレベルの信頼性によって異なる場合があります, 料金, 追加機能, および全体的なサイズ. 名前が示すように, CSPのパッケージサイズは、チップダイサイズとほぼ同じです, これはその主な利点の1つです. WLP製造プロセスを採用することにより, CSPは、可能な限り最小のパッケージダイサイズ比を達成するために常に開発されています. 図に示すように 2, ボールグリッドアレイ (BGA) パッケージ内のCSPのスタイルは、PCB配線を簡素化しながら、いくつかの相互接続を可能にします, PCBアセンブリのスループットの増加と製造コストの削減.
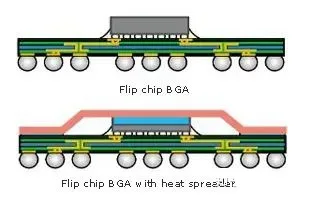
ウェーハレベルのパッケージ
その他のカプセル化技術
アプリケーションカスタマイズされたモジュールパッケージへのシームレスな統合を可能にする統合ICパッケージには、他にもいくつかの形式があります. クワッドフラットパッケージ (MF) 最も初期のSurface-Mount ICパッケージテクノロジーの1つです,パッケージの構造は、拡張された相互接続リードを備えた4つの側面で構成されています, 図に示すように 3(a). 上昇したリードはパッケージフレームに接続されており、金属insulatorメタルを形成します (ミム) リードとチップダイメタルの間のタイプコンデンサ, 一致する要素として使用できます. この手法は、パッケージの周辺ピンの数がより多く到達できるミリメートルサイズのICに適しています 100 ピン. このタイプのカプセル化にはいくつかの導関数があります, 使用する材料に応じて, セラミッククワッドフラットパックなど, 薄いクワッドフラットパック, プラスチッククワッドフラットパック, プラスチッククワッドフラットパック) およびメタルクワッドフラットパック (MQFP). QFN, クワッドフラットリードなし, 図に示されています. 3(b) フラット銅のリードフレームとラジエーターの熱伝達パッドとして使用されるプラスチックパッケージから形成されたいくつかの表面に取り付けられたパッケージングテクノロジーの1つです。. ワイヤーボンディングは、相互接続にも使用できます, そして、結合ラインは導体であるだけでなく、インダクタであるため, それらは一般に、このカプセル化技術に基づくデバイスのパフォーマンスに影響を与えます, それが全体的なデザインの一部と見なされない限り. QFNは4つの側面で構成される相互接続ですが, Bi-Plane UNLEDがリードしています (DFN) また、相互接続平面リードの両側に表示され、形成されます.
 UGPCBのロゴ
UGPCBのロゴ