Substrate Products Roadmap
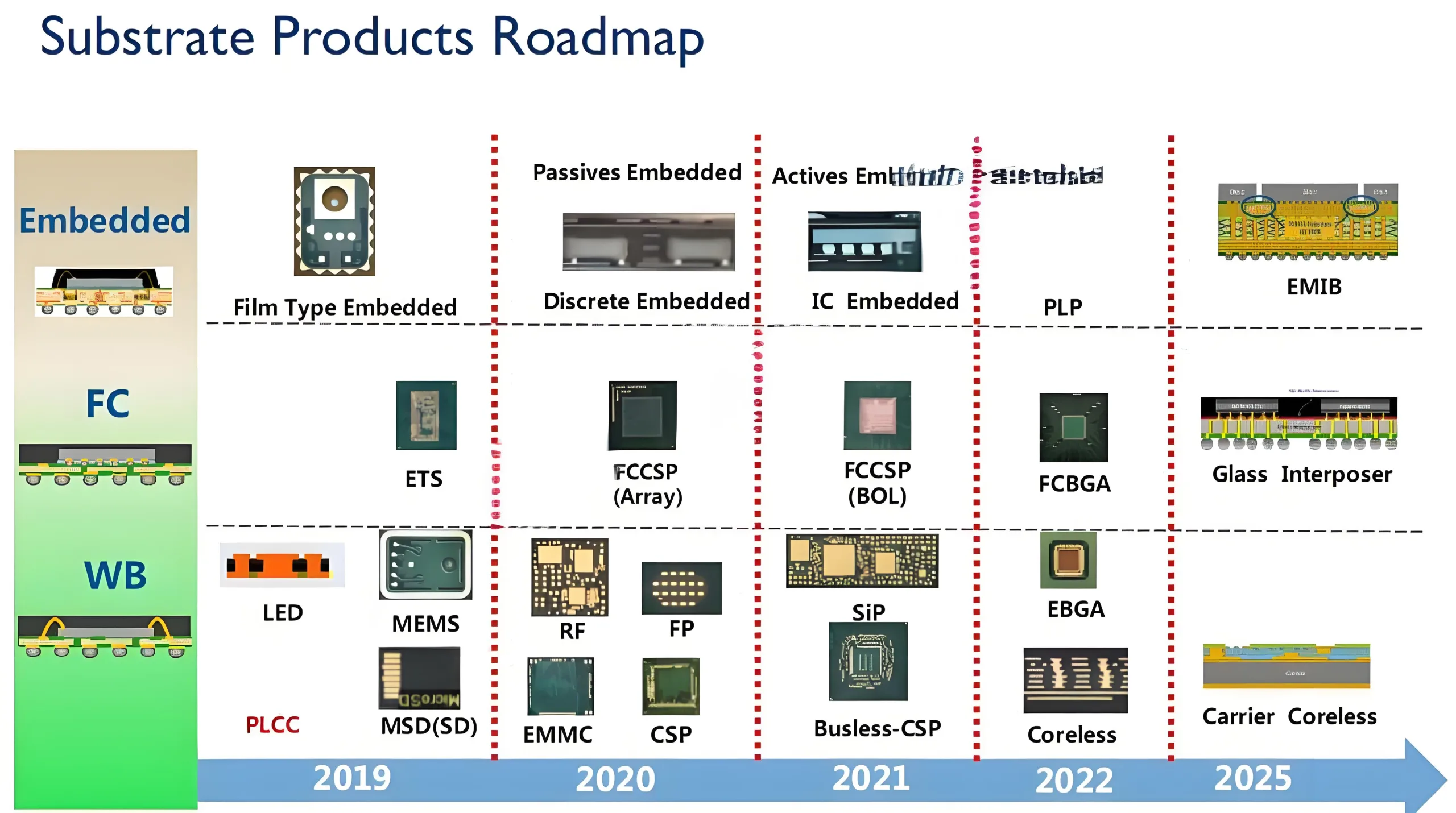
Substrate Products Roadmap
Дорожная карта субстрата 1

Дорожная карта субстрата 1
Дорожная карта субстрата 2

Substrate Products Roadmap 2
System-In-Package Substrate (Глоток)
System-In-Package-это системная платформа, которая собирает несколько гетерогенных пластин, чувствительные компоненты, пассивные компоненты, и т. д., в один пакет. Его приложения включают многоцелевой модуль (МСМ), Многочисленная пакет (MCP), Сложный пакет чипов, пакет в пакете (Пип), и встроенная компонентная плата носителей. System-In-Package предоставляет дизайнерам систем IC другое решение для интеграции вычислительной функции, помимо системы на шипе (SoC). Он имеет преимущества интеграции гетерогенных чипов из разных источников, быть меньше и тоньше, и быстро выходить на рынок.
SIP может быть мульти-чип-модулем (Многоошип модуль; МСМ) Планарный 2D -пакет, и также может повторно использовать структуру 3D -пакета, чтобы эффективно уменьшить площадь упаковки, и ее внутренняя технология связывания может быть чистым проволочным соединением (Проволочная связь), Flipchip также можно использовать, Но они также могут быть смешаны. В дополнение к 2D и 3D -конструкциям упаковки, Еще один способ интеграции компонентов с многофункциональными субстратами также может быть включен в объем SIP. Эта технология в основном внедряет различные компоненты в многофункциональный субстрат, и также может рассматриваться как концепция SIP для достижения цели функциональной интеграции. Различные меры чипа и различные технологии внутренних связей позволяют типам пакетов SIP для производства диверсифицированных комбинаций. UGPCB может быть настроен или гибко произведен в соответствии с потребностями клиентов или продуктов.
Пластиковая шар -шар (PBGA)
Это самый базовый подложка для массива шаровых затворов, используемый в соединении и упаковке проволоки. Его основной материал - это подложка для медной фольги, пропитанную стеклянным волокном. Пластиковая упаковочная подложка для массива затворов для пластиковых шариков может быть применена к упаковке Chip с относительно высоким количеством штифтов. Когда функция чипа обновляется, Традиционная структура пакета ведущих кадров становится неадекватной с увеличением количества выходных/входных контактов, и пластиковой пакет пакета массива шариков обеспечивает экономически эффективное решение.
Пакет пакета шкалы Flip Chip (FCCSP)
Чип полупроводника не подключен к подложке с помощью проволочной связи, но взаимосвязан с подложкой с помощью ударов в состоянии флип-чипа, так называется FCCSP (Пакет шкалы Flip Chip Chip). Упаковка размеров на уровне пластины флип-чипа еще больше покажет преимущество затрат. В недавнем прошлом, Стоимость процесса неровностей на платежах также продолжала падать, что также привело к более быстрому снижению затрат на упаковку. Упаковка размера чипов с флип-чип.
Пакет пакет массива шариков с переливным чипсом подложки (FCBGA)
ФК-БГА (Массив сетки с мешочкой) Substrate-это подложка с полупроводниковым пакетом высокой плотности, которая может реализовать высокоскоростную и многофункциональную чипов LSI. Пакет массивов массивов шар для шар-чипа имеет очень превосходные преимущества производительности и затрат в пакете очень высокого количества выходных/входных контактов, такой как чип, такой как микропроцессор или процессор изображения.
Если вам нужен IC Substrate, Пожалуйста, не стесняйтесь обращаться к UGPCB, электронная почта: sales@UGPCB.com
 ЛОГОТИП УГКПБ
ЛОГОТИП УГКПБ

Вичат
Сканируйте QR-код с помощью WeChat